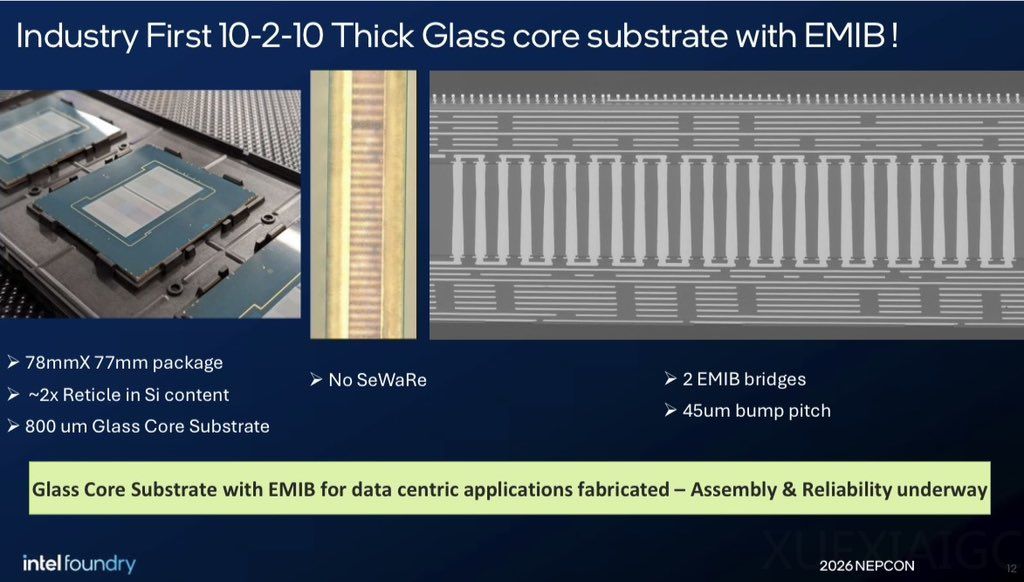
文章摘要
【关 键 词】 半导体、先进封装、芯片技术、行业趋势、巨头竞争
半导体行业正经历从工艺制程竞争向先进封装技术转型的关键阶段。随着AI芯片爆发、HBM内存普及及高速信号传输需求增长,先进封装成为提升芯片性能、降低功耗的核心手段。市场预测显示,2025年全球半导体市场规模将达7934亿美元,而先进封装技术凭借其优势,市场规模有望在2028年突破794亿美元。台积电、Intel和三星三大巨头近期纷纷加码布局,技术路线与产能扩张同步推进,行业竞争进入白热化。
台积电通过多技术路线并行策略保持领先地位,其晶圆级多芯片模组(WMCM)技术计划于2026年量产,采用重布线层替代传统中介层,显著提升互连密度与散热性能,适配苹果A20芯片,推动封装技术向消费电子领域下沉。WMCM不仅优化信号传输路径,还降低制造成本,为移动终端AI算力释放提供支撑。
Intel则聚焦材料创新,展示了结合EMIB与玻璃基板的封装方案。玻璃基板凭借更佳的平整度与热稳定性,突破传统有机基板限制,支持超精细布线与大尺寸芯片集成。Intel通过“No SeWaRe”技术解决玻璃脆性问题,目标在2026-2030年实现量产,瞄准AI服务器与高性能计算市场,强化其差异化竞争力。
三星以散热技术为突破口,在Exynos 2600处理器中导入Heat Pass Block(HPB)技术,通过铜基导热块优化热量传导路径,实现热阻降低16%、芯片温度下降30%的效果。HPB技术从封装层面系统性解决散热瓶颈,为高性能移动SoC提供新方案,但同时也面临体积、成本等工程挑战。
2.5D/3D封装技术作为当前主导路线,增长潜力显著,广泛应用于AI芯片与高端存储器。台积电CoWoS产能持续扩张,2026年目标占比营收10%;Intel通过EMIB、Foveros等技术构建Chiplet生态;三星则依托SAINT技术体系强化存储与逻辑芯片协同封装能力。此外,光电合封(CPO)技术被视为未来高速传输的关键,有望突破电互联带宽限制。
先进封装技术正朝着材料革新、异构集成、散热优化与光电融合等方向演进。玻璃基板、新型复合材料等突破传统限制,异构集成通过UCIe等标准推动多芯粒协同,热管理从封装层级渗透至系统级,而光电合封技术则为数据中心高速互联提供终极解决方案。
后摩尔时代,封装技术从“配角”跃升为决定芯片性能的“主角”。三大巨头的布局不仅重塑行业竞争格局,也为半导体产业的未来发展指明方向。掌握核心封装技术的企业将在新一轮技术迭代中占据制高点,引领产业迈向更高集成度、更低功耗与更强性能的新阶段。
原文和模型
【原文链接】 阅读原文 [ 6107字 | 25分钟 ]
【原文作者】 半导体行业观察
【摘要模型】 deepseek/deepseek-v3-0324
【摘要评分】 ★★★★★



