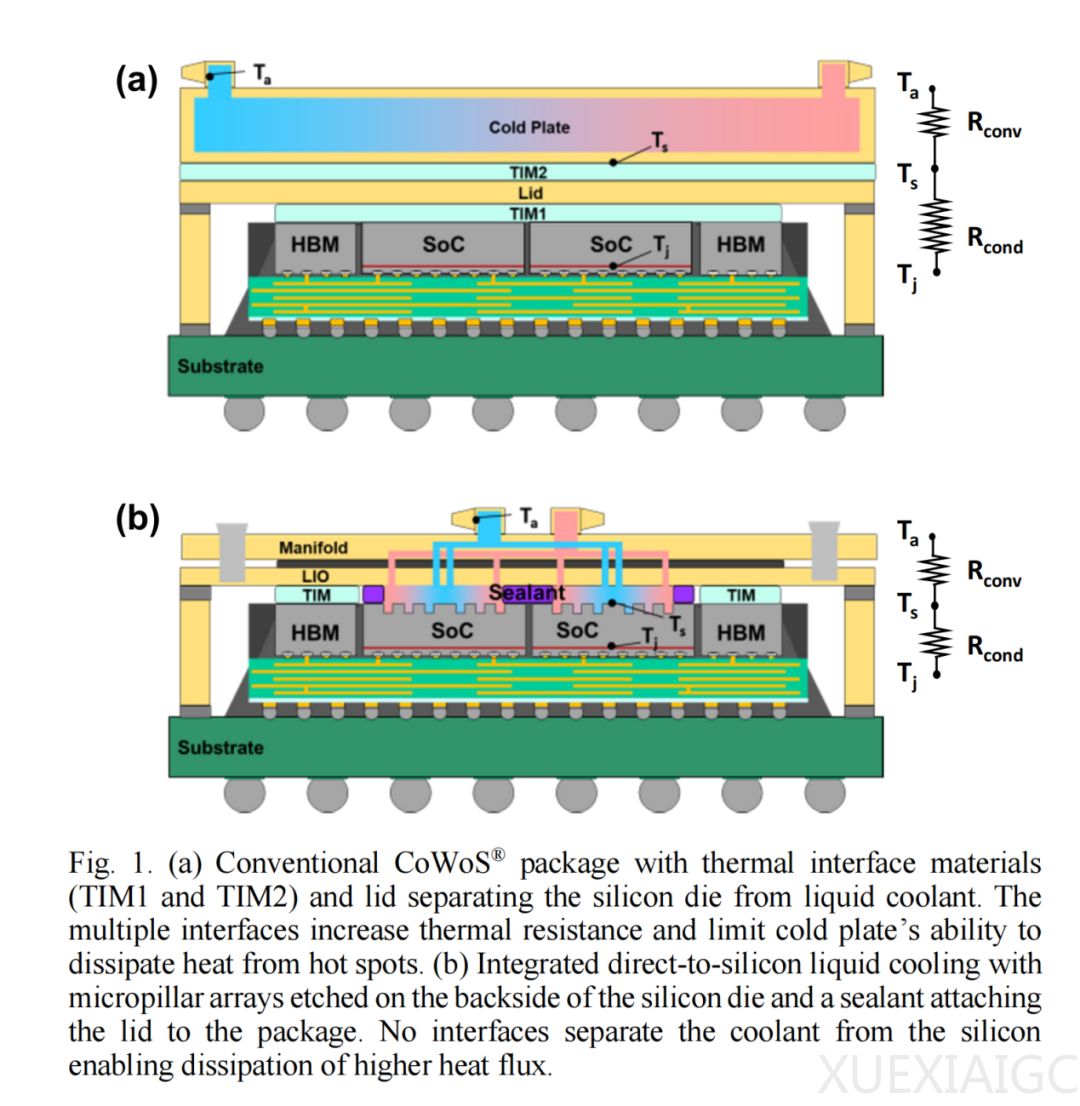
文章摘要
【关 键 词】 液冷技术、高性能计算、先进封装、散热方案、数据中心
台积电工程师团队成功开发了一种名为硅集成微型冷却器(IMC-Si)的直接硅基液冷解决方案,并将其集成到3.3倍光刻CoWoS-R封装平台上。该技术通过将液态冷却剂直接输送到硅芯片背面,显著提升了散热效率,在40℃水温、10 LPM流速条件下,可实现3.4 kW的总散热功率和2.5 W/mm²的均匀热通量。这一突破性进展为应对高性能计算和人工智能应用中日益增长的散热需求提供了有效解决方案。
该集成方案仅需对现有CoWoS工艺流程进行少量修改,在硅逻辑芯片和液冷歧管盖之间涂覆抗翘曲密封剂形成防漏气室。测试数据显示,其氦气泄漏率(4.4 x 10⁻⁶ Pa·m³/s)比数据中心环境临界值低一个数量级,并通过了包括多次回流焊、2000次热循环和150℃高温存储测试在内的严格可靠性验证。加速液体浸没测试(150℃、4.8 bar压力)进一步证实密封剂在极端条件下仍能保持优异防漏性能。
与传统间接冷却方案相比,IMC-Si技术消除了热界面材料带来的热阻瓶颈。在未图案化硅表面进行液冷时,5.6 LPM流速下即可实现1.7 kW散热能力;当在SoC背面集成微柱阵列后,冷却效率提升50%,10 LPM流速下功率密度达到2.5 W/mm²。研究还发现,虽然3.3X CoWoS-R封装存在160-190μm翘曲,但弹性体密封剂能有效适应这种形变,维持稳定的冷却性能。
可靠性测试采用创新性评估方法,结合开放计算项目指南和NASA标准,建立了氦气泄漏率与液体泄漏率的换算模型。经过2000次温度循环和1000小时高温存储后,密封剂仍保持初始泄漏率水平,证明其在长期热机械应力下的稳定性。有机中介层的应力缓冲作用也有效缓解了热失配问题,提升了焊点和互连的机械可靠性。
这项研究首次证实了直接硅液冷技术与先进封装平台的兼容性,为下一代高性能计算系统的热管理提供了可扩展的解决方案。未来工作将聚焦于微柱结构优化和翘曲控制,以进一步提升冷却效率。该技术的成功开发标志着数据中心液冷技术从传统冷板向芯片级直接冷却的重要演进,有望突破异构集成系统的散热限制。
原文和模型
【原文链接】 阅读原文 [ 4218字 | 17分钟 ]
【原文作者】 半导体行业观察
【摘要模型】 deepseek/deepseek-v3-0324
【摘要评分】 ★★★★★



