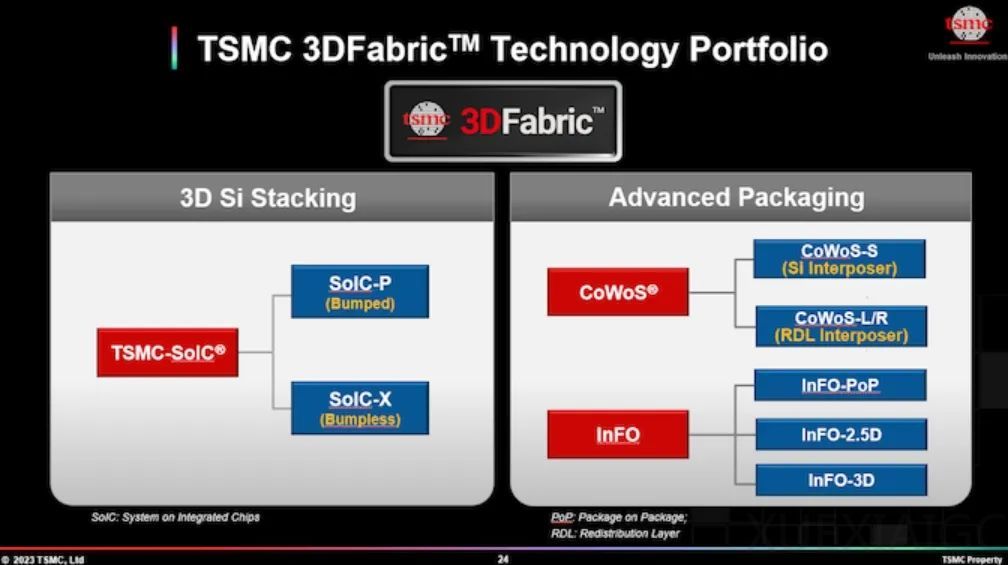
文章摘要
【关 键 词】 台积电、3D堆叠、SoIC技术、先进封装、高性能计算
台积电的3D堆叠系统级集成芯片(SoIC)先进封装技术预计将迅速发展。该技术涉及将两个先进的逻辑器件直接堆叠,通过超密集的连接来提升高性能部件的表现。
到2027年,台积电计划将SoIC技术的凸块间距从现有的9μm缩小至3μm,使得能够将1.6纳米级的A16芯片与2纳米级的N2芯片通过3μm键合间距的硅通孔(TSV)连接,提升组装芯片的带宽密度。
此外,台积电还计划推出针对低成本、低性能应用的凸块SoIC-P封装工艺。到2025年,将提供能将0.2光罩大小的N3顶部芯片与N4底部芯片配对的正面对背面(F2B)凸块技术,使用25μm间距微凸块进行连接。
2027年,将推出正面对背面(F2F)凸块技术,实现N2顶部芯片与N3底部芯片的16μm间距堆叠。
台积电对SoIC技术的行业采用持乐观态度,预计到2026年至2027年间将推出约30种SoIC设计。为了让SoIC更受芯片开发商欢迎,台积电还需持续改进芯片到芯片的接口技术。
通过这些技术进步,台积电期望为不同性能需求和应用成本提供多元化的封装解决方案,进一步巩固其市场领导地位。
原文和模型
【原文链接】 阅读原文 [ 1114字 | 5分钟 ]
【原文作者】 半导体行业观察
【摘要模型】 glm-4
【摘要评分】 ★★☆☆☆
© 版权声明
文章版权归作者所有,未经允许请勿转载。
相关文章
暂无评论...



