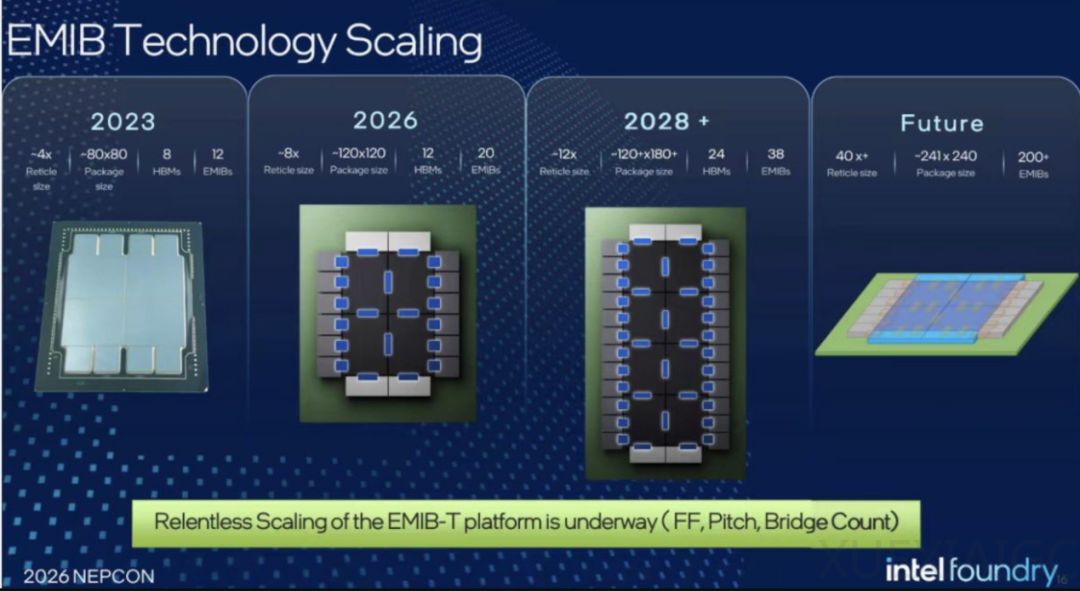
文章摘要
【关 键 词】 半导体、人工智能、节能计算、先进封装、生态协作
半导体行业正处于关键时刻,人工智能激发出对计算性能、内存带宽和系统级创新的空前需求,推动行业进入结构性转型而非普通市场周期,同时也带来电力限制、供应链压力、成本攀升、技术复杂等多重超出传统晶体管尺寸缩放范畴的挑战。在SEMI产业战略研讨会上,AMD与英特尔的高管分别从互补角度阐述行业如何满足AI时代需求,演讲核心围绕节能计算、系统级协同优化、先进封装与互连创新、供应链韧性、生态协作等主题展开,当前半导体创新正从以器件为中心的规模化,转向对晶圆制造工艺、封装、架构和系统集成的整体优化。人工智能不是普通的应用浪潮,而是从根本上重塑了半导体技术的需求,成为半导体增长的结构性驱动力。AI工作负载对算力、内存带宽、互连吞吐量提出指数级增长需求,训练集群规模的大幅扩张显著提升了系统功耗与数据传输需求,创新场景从芯片层面扩展至集群层面,蛮力式规模扩展在商业层面不具备可行性,提升效率成为必然方向。
在人工智能时代,每瓦性能已经取代频率提升和晶体管密度,成为半导体技术进步的核心衡量指标,能源效率成为主要设计约束条件。AI工作负载以并行计算和数据传输为主,缩短计算与内存的距离是降低能耗的核心手段,异构集成、内存邻近成为关键设计策略,3D堆叠等先进封装可紧密集成计算与存储,大幅降低传输能耗,行业范式已经转向以更低电压提供算力,而非单纯最大化运行频率。节能型AI架构普遍采用Chiplet方案替代整体式设计,允许不同功能模块适配最优工艺节点,提升性能与能效,AMD MI300就是该架构的典型实践。
设计技术协同优化,即将架构选择与封装和工艺技术相结合,已经取代单纯的晶体管尺寸缩小,成为提升人工智能计算密度和效率的核心路径,系统架构决策对能源效率的影响已经与工艺节点选择相当。工艺技术依然是提升能效的关键,当前节能优化围绕功耗管控、寄生效应降低、器件性能改进三个方向展开,新兴互补场效应晶体管架构有望将芯片级功耗最高降低30%,拓展节能缩放的空间,工艺创新需要服务于系统级效率目标,而非独立器件指标。封装已经从辅助技术升级为核心性能驱动因素,先进封装与3D互连可大幅提升互连能效,适配AI工作负载对数据传输能效的需求,电源管理与散热也成为核心设计挑战。随着AI集群规模扩张,系统互连效率的重要性已经和芯片级性能相当,电互连接近物理极限推动行业布局共封装光学等光互连技术,当前行业还面临先进制造投资高、复杂度提升、供应链压力加剧等问题,全生态范围的协作是应对挑战的核心,统一通用规范、构建开放生态可以集中投资、加快创新落地、降低供应链风险,保障行业可持续发展。
原文和模型
【原文链接】 阅读原文 [ 2832字 | 12分钟 ]
【原文作者】 半导体行业观察
【摘要模型】 doubao-seed-2-0-lite-260215
【摘要评分】 ★★★☆☆



