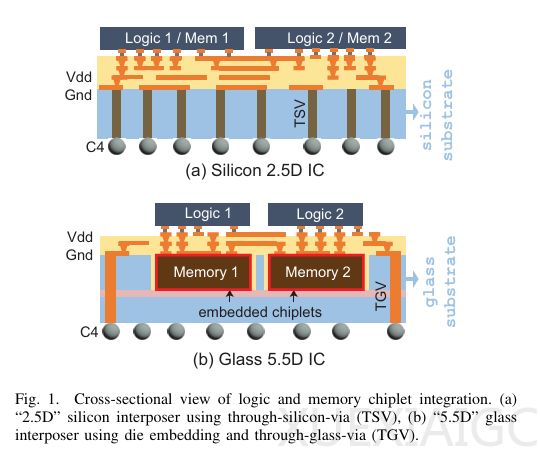
文章摘要
玻璃中介层在3D堆叠技术中的应用展现出显著优势,特别是在支持嵌入基板的芯粒与直接堆叠于顶部的芯粒之间的连接方面。与传统的硅中介层相比,玻璃中介层在多个关键系统级指标上表现优异,包括面积优化、线长缩短、信号完整性提升、电源完整性改善以及热完整性管理。实验数据显示,玻璃中介层可实现2.6倍的面积优化、21倍的线长缩短、全芯片功耗降低17.72%、信号完整性提升64.7%、电源完整性改善10倍,尽管温度会升高15%。
玻璃中介层的独特优势在于其允许芯粒嵌入基板的能力,这为3D堆叠提供了天然的支持。这种嵌入能力不仅降低了成本,还通过再分布层(RDL)实现了短距离的芯片间“微过孔”互连。玻璃中的互连间距和玻璃通孔(TGV)直径逐渐与硅中介层相当,使得玻璃成为2.5D异构集成的有力候选方案。
在系统级对比中,玻璃中介层在功耗、性能、面积(PPA)、信号完整性(SI)、电源完整性(PI)和热完整性(TI)方面均表现出色。通过签核品质设计与精确仿真,玻璃中介层的制造成本得以估算,进一步验证了其在5.5D堆叠中的潜力。玻璃中介层的制造工艺也展示了其在大尺寸面板上实现高密度布线的能力,最小线宽/间距为2微米,与硅中介层相当。
在芯粒设计与仿真设置中,玻璃中介层展现出最小的芯粒占位面积和最短的布线长度,这得益于其微凸点间距最小。尽管硅中介层的凸点间距较大,但其内存芯粒尺寸与玻璃中介层相同,因为内存宏块是决定芯粒面积的限制因素。玻璃中介层的芯粒功耗与性能与其他中介层相近,但其I/O驱动器在总功耗中占比较小。
中介层布局与布线结果显示,玻璃中介层使用最少的金属层,实现了最短的总布线长度。其独特的垂直堆叠结构充分发挥了芯粒嵌入的优势,而其他中介层则采用并排布局。玻璃中介层在信号与电源完整性方面表现最佳,眼图最宽,PDN阻抗最低,展现出最快的稳定时间和最低的电压跌落。
热可靠性分析表明,玻璃中介层的内存芯粒温度较其他中介层略高,但逻辑芯粒温度较低,整体热分布合理。玻璃中介层的逻辑与内存芯粒最高温度分别为31.7°C与27.5°C,而其他中介层内存芯粒温度约为23.3°C。有机材料的APX中介层由于其介电材料的热性能最差,散热效果最差。
综上所述,玻璃中介层在5.5D IC芯粒集成方案中展现出显著优势,特别是在布线长度更短、芯粒面积更小以及信号与电源完整性更优等方面。合理进行芯粒分区设计,可保证嵌入式芯粒在工作温度范围内正常运行,进一步推动玻璃中介层在3D堆叠技术中的应用。
原文和模型
【原文链接】 阅读原文 [ 6265字 | 26分钟 ]
【原文作者】 半导体行业观察
【摘要模型】 deepseek-v3
【摘要评分】 ★★★★★



