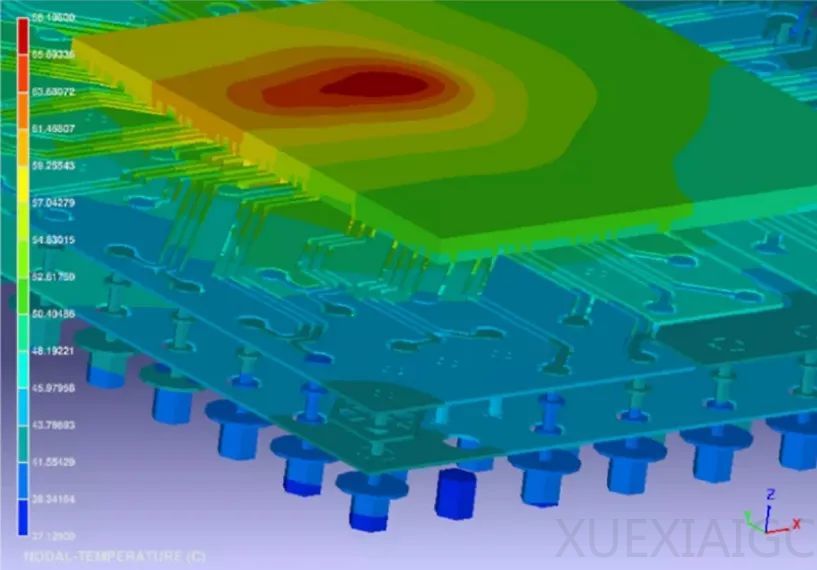
文章摘要
【关 键 词】 3D-IC技术、热管理、工艺变化、翘曲问题、设计优化
随着3D-IC技术的发展,热管理和工艺变化成为了设计中的重要挑战。3D-IC通过将不同工艺节点开发的异构设备集成到同一封装中,突破了平面SoC的极限,但同时也带来了热问题和工艺变化的复杂性。
热问题在3D-IC中尤为突出,可能导致自发DRAM刷新、热失控等问题。在光子学应用中,热量还会干扰通信。热量和工艺变化可能是独立的问题,也可能是彼此问题的乘数,需要有远见才能解决。
翘曲是3D-IC面临的首要问题,由于高度堆积的异质材料配置和基板变薄,热致翘曲已成为持续问题。翘曲可能导致机械故障和芯片间连接破裂。
为了应对热问题,设计人员需要在最佳性能规格和不配合的物理现实之间找到平衡。热分析需要考虑整个设计,而不仅仅是芯片本身。
左移可以帮助创建更稳健、更可靠的设计,通过减少迭代次数加快整个设计过程。改变传统工作流程虽然具有挑战性,但从长远来看将更具成本效益。
总之,热问题和工艺变化是3D-IC设计中的重要挑战,需要设计人员在性能和物理现实之间找到平衡。通过左移、预测问题和改变传统工作流程,可以创建更稳健、更可靠的设计。同时,提高可靠性和跨领域合作也是解决这些问题的关键。
原文和模型
【原文链接】 阅读原文 [ 3576字 | 15分钟 ]
【原文作者】 半导体行业观察
【摘要模型】 moonshot-v1-32k
【摘要评分】 ★★★★★
© 版权声明
文章版权归作者所有,未经允许请勿转载。
相关文章
暂无评论...



